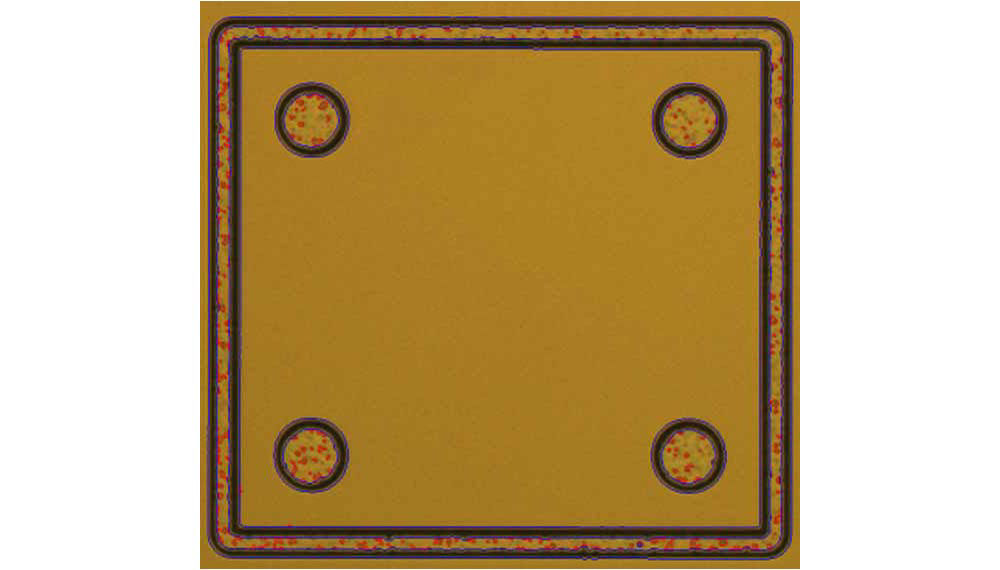
コントラストの差を測定し、フォトレジスト汚染などの不良を検出します。
ニコンの「ウェハ自動計測ソリューション」は、半導体製造の後工程を中心にコスト課題を解決するソリューションです。画像測定システム「NEXIV VMZ-S3020」とLSI検査顕微鏡用ウェハローダ「NWL200」を組み合わせることで、従来の自動光学検査(AOI:Automated Optical Inspection)装置に比べて資本投資を抑制します。さらに、柔軟な測定プログラミングと高速処理により、生産性の向上と品質の安定化に貢献します。
半導体の生産体制におけるコスト削減の主な課題
解決へのアプローチ
ニコンは、長年培ってきた計測機器の技術とノウハウで、半導体製造における上記の課題を解決に導きます。
アプローチ1
専用のAOI装置に比べ、資本投資を半減できます。必要な箇所のみを検査する柔軟な運用でダウンタイムも抑制します。
アプローチ2
高い測定再現性で不良リスクを早期に発見し、歩留まりを改善。自動搬送システムと高速計測により、マニュアル測定と比較してスループットを6倍に向上させます。
アプローチ3
直感的なGUIとシンプルな操作性により、オペレーターのスキルレベルを問わず、誰でも同じ測定結果を得られる環境を構築します。
電気自動車や自動運転技術の普及を背景に、半導体の重要性はますます高まっています。その生産現場では、歩留まりやスループットの改善、運用の簡素化といったテーマが、コスト削減における重要な経営課題となっています。
特にウェハレベルの品質管理で用いられる専用のAOI装置は、設備投資が高額になりがちです。また、厳密な手順でウェハ全面をスキャンするため、検査要件の変更時に大きなダウンタイムが発生するケースも少なくありません。ニコンはこれらの課題に対し、計測機器の観点から新たなソリューションを提案します。
ニコンの「ウェハ自動計測ソリューション」は、画像測定システム「NEXIV VMZ-S3020」とLSI検査顕微鏡用ウェハローダ「NWL200」を組み合わせたシステムです。高価な専用装置に代わる、低コストで柔軟性の高い検査体制を構築します。
本ソリューションは、計測工程の高速化と効率的な搬送システムにより、大幅なスループット向上を実現します。
ウェハをカセットから測定機へ自動で搬送するLSI検査顕微鏡用ウェハローダ「NWL200」により、人による操作は一切不要です。検査後、不良が見つかったウェハは再加工へ、正常なウェハは下流のバックエンド工程へと自動で振り分けられます。これにより、マニュアル測定と比較してスループットは6倍向上します。
また、測定自体も高速です。200 mm(8インチ)ウェハの場合、中心部の9領域の画像取得と測定が約10秒で完了。ウェハ周辺部の検査も4分のサイクルで完了し、180枚の分析用画像を生成します。
ニコンが誇る高精度の光学系と精密なステージコントロールが、高い測定再現性を実現します。信頼性の高い傾向管理を可能にし、製造現場のリスクを早期に発見することで歩留まり改善に貢献します。
自社開発のリニアエンコーダを搭載し、すべての軸で0.01 μm(10 nm)という高分解能を達成。これにより、0.8 μmという高精度な限界寸法(CD:Critical Dimension)計測が可能です。
標準ソフトウェアAutoMeasureにより、検査実行中に照明の調光をプログラム可能。短絡や将来的な機能不全の原因となりうる微粒子まで高精度に検出します。
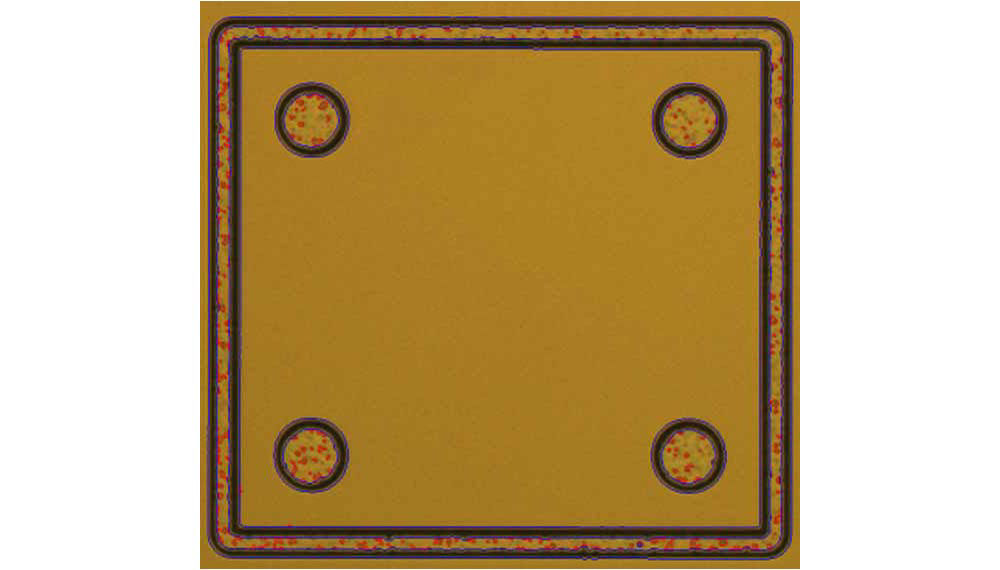
コントラストの差を測定し、フォトレジスト汚染などの不良を検出します。

背景やパターンと比較して明るく映る粒子を検出し、半導体表面の傷や微粒子の有無を確認します。

明度によりシールリング内部の不良を検出します。
本ソリューションは、オペレーターのスキルに依存しない、シンプルで柔軟な運用プロセスを実現します。
シンプルなGUIにより、測定したい項目を直感的に選択できます。これにより、誰でも簡単に同じ測定結果を得られます。標準ソフトウェアAutoMeasureを使用することで、特定の領域を指定する測定プログラムも容易に作成できます。作成した測定プログラムはコピーもできるため、運用プロセスをさらに簡素化できます。
また、システムはコンパクトで、故障発生までの平均時間が長くメンテナンスコストが低いことも特長です。業界標準のSECS/GEMプロトコルに対応しており、ホスト設備とのデータ連携もスムーズです。
試験導入を実施した企業では、本ソリューションの柔軟性が高く評価されました。
同社では、200 mm(8インチ)および150 mm(6インチ)のウェハに対し、全面ではなく外周部と中心付近の特定領域のみ精密な寸法測定が必要でした。本ソリューションでは、このような独自の要件に合わせたスキャンシーケンスを容易に作成できるため、必要な品質管理を低コストで実現しました。
ニコンの「ウェハ自動計測ソリューション」は、半導体製造工程におけるコストを削減し、人と機械が共創する生産性の高い環境づくりを推進します。高精度な計測技術で製造現場の課題を解決し、歩留まり改善・スループット向上・運用簡素化を実現します。
ニコンは「ニコン調達基本方針」を掲げ、より良い社会と地球環境づくりに配慮した持続可能なものづくりを実践しています。これからも、お客様の課題に寄り添うソリューションを提供し、持続可能な社会の実現に貢献していきます。
さまざまなサンプルをカバーする汎用モデルです。μm台の公差管理を高速/高精度/使いやすく行えます。
光学顕微鏡と組み合わせたミクロ検査、目視によるマクロ検査が可能なウェハローダです。
測定プログラム作成サポート機能がさらに充実し、豊富な機能と分かりやすいGUIで高精度/スピーディー/簡単に寸法測定を行えます。
株式会社ニコン
インダストリアルソリューションズ事業部
製品カタログのご希望、製品仕様に関するお問い合わせ、デモのご相談など、下記のお問い合わせフォームよりお気軽にお問い合わせください。